The significance of X-RAY detection of BGA bubbles and voids
Release time:2024-07-22Publisher:Jeenoce
With the technological and precision development of electronic products, more and more enterprises are paying attention to product quality, especially since electronic products are often prone to poor contact, which has led to urgent quality control. Therefore, more and more enterprises are striving to achieve the utmost attention to detail, among which SMT is a very critical part.
The main purpose of X-ray inspection of BGA (Ball Grid Array) bubbles is to ensure the quality and reliability of electronic devices. The formation of bubbles below BGA solder joints may cause the following problems:
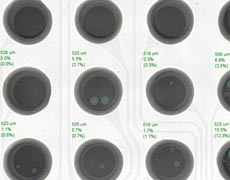
1. Welding quality issue: Bubbles may affect the wettability of the solder, causing the solder to not fully wet the welding surface, thereby affecting the welding quality. This may result in weak soldering, thereby affecting the performance and reliability of electronic devices.
2. Electrical connection issues: Bubbles may cause poor or intermittent electrical connections at solder joints, thereby affecting the functionality of electronic devices. This may result in signal transmission interruption, decreased electrical performance, or equipment failure.
By detecting BGA bubbles through X-ray, the size, distribution, and location of bubbles can be detected and evaluated in a timely manner, and measures can be taken to solve problems in a timely manner. This helps ensure the quality and reliability of BGA soldering, improve the performance and lifespan of electronic products, while reducing maintenance costs and production losses caused by soldering issues.
BGA (Ball Grid Array) is a common packaging technology, and bubble cavities may form below its solder joints, which can lead to poor soldering or electrical connection issues. X-ray inspection is a commonly used method for detecting the presence of air bubbles and voids in BGA connections. In X-ray inspection, X-rays pass through BGA components, and bubbles and voids produce densities different from the surrounding materials, which are therefore visible in X-ray imaging. This method can effectively detect air bubbles and voids in BGA connections, ensuring the quality of soldering and the reliability of electrical connections.

